OERプロセス技術を使用して常温でハイバリア成膜に成功しました
株式会社明電舎(取締役社長:三井田 健 / 東京都品川区、以下明電舎)は、世界で初めて注1OER(Ozone-Ethylene Radical generation technology)プロセス技術と常温環境下のキャリアガス(酸化膜の元を運ぶガス)を利用して、原子レベルの膜を積層する新しいALD(Atomic Layer Deposition)成膜技術を確立しました(以下本技術)。
本技術の研究開発は国立研究開発法人産業技術総合研究所と共同で行い、2019年2月に特許出願済みです。
本技術により、熱ダメージに弱いプラスチックフィルム及び極薄フィルム上に成膜が可能となります。極めて低い蒸気透過性なので高品質であり、製造工程の消費エネルギーも抑制することができます。具体的には、半導体やディスプレイの封止、2次電池の部品や、自動車部品などの改質など幅広い分野への応用が期待できます。
OERプロセス技術とは、明電舎のピュアオゾンジェネレータの高純度オゾンとエチレンガスを反応させ常温で高活性なOHラジカルを発生させる明電舎独自の技術です(当社特許取得済み)。この技術を活用すると、常温で有機物(金属以外の物質)の改質、成膜、洗浄が可能です。OERプロセス技術を用いた成膜においては、2018年4月に、常温CVD成膜に成功しており注2(2018年4月プレスリリース)、この度、より高密度な常温ALD成膜にも成功しました。
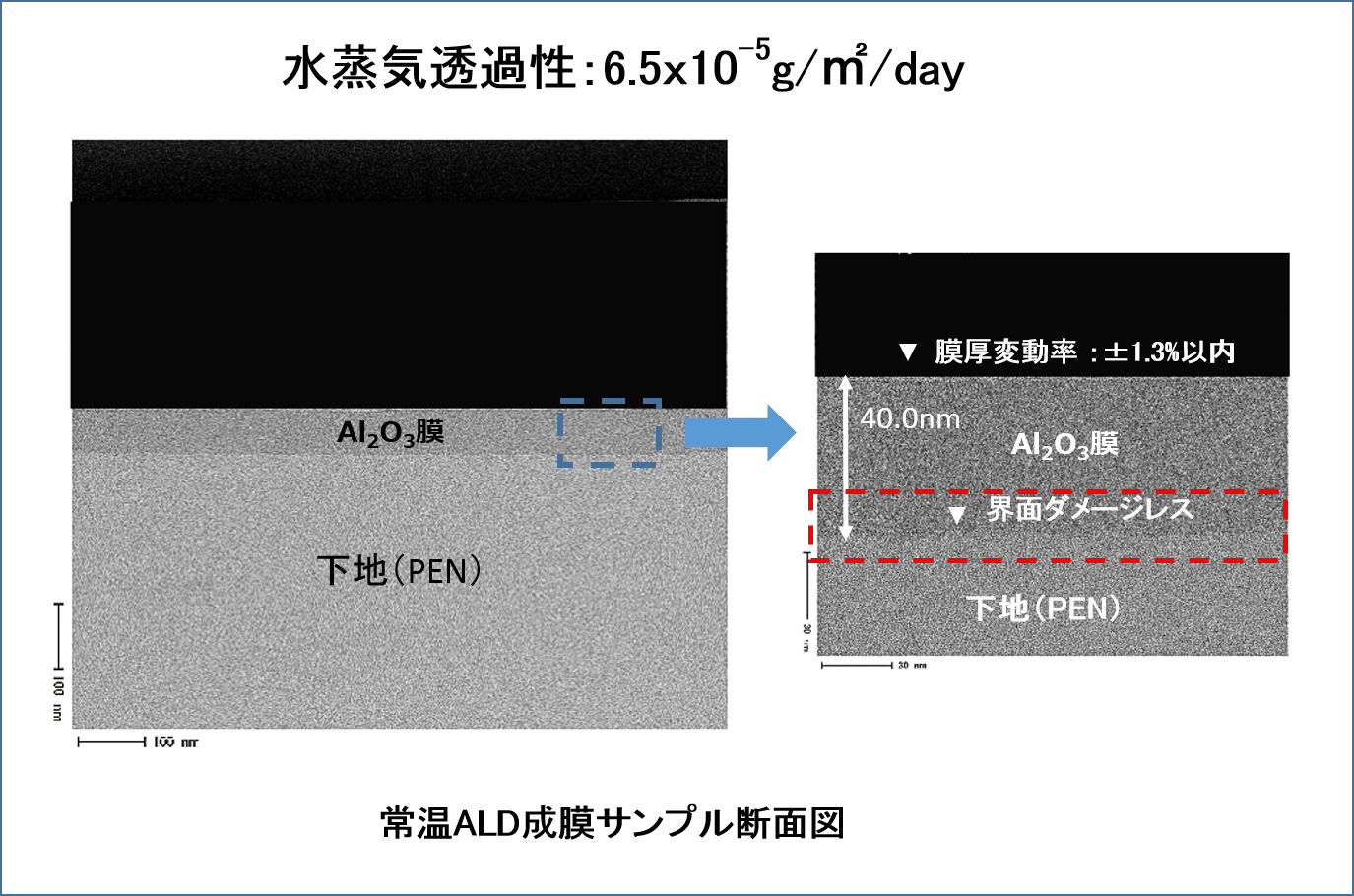
この研究開発において常温ALD成膜で、フィルム上にAL2O3単層膜で膜厚40nm、バリア性6.5x10-5g/㎡/day注3のハイバリア成膜ができました。
現在、OER-CVD成膜と共に更なる高品質化に向けて取り組んでいます。
明電舎は、今後本技術より、ピュアオゾンジェネレータを組み込んだ常温CVD成膜、ALD成膜の両方が可能なOERプロセス装置を開発し、販売してまいります。
注1:明電舎調べ
注2:2018年4月17日付プレスリリース
ピュアオゾンを使用し、常温で酸化膜を作る技術を開発しました
https://www.meidensha.co.jp/news/news_03/news_03_01/1242719_10499.html
注3:24時間中に透過する水分のグラム数値
《OER-ALD成膜プロセス図》
常時、キャリアガス排気で<①+②→①→③→①>のサイクル成膜を行う。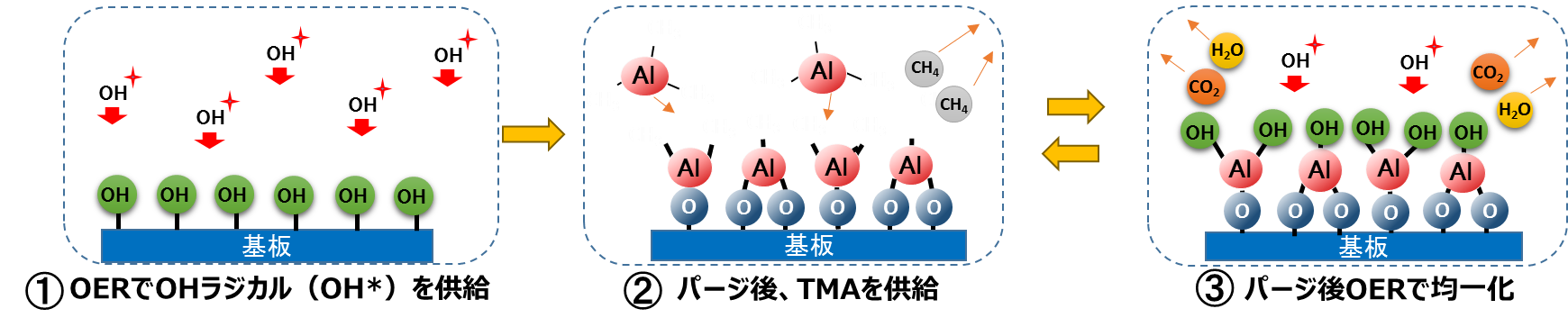
TMA: Trimethyl Aluminum(トリメチルアルミニュウム)ガスと呼ばれるもので酸化膜の素(ソースガス/プリカーサーとも言う)になるガスでAL2O3(アルミナ)膜が作れる。主にALD成膜に使われる。
常温OER-ALD成膜の特長
・従来100~200℃のエネルギーを必要としたが常温まで引き下げられ消費電力を低減し膜製造コストを削減できます。
・熱ダメージを与えないフィルムなど低温素材への成膜が可能とします。
・従来、成膜レイヤー毎に真空排気をする必要があったが、常時キャリアガス排気をすることにより真空排気処理時間の短縮を可能とします。
・OER成膜技術はシャワーヘッドを用いたガス流のため、制御系を変更するだけでALD/CVDのどちらの成膜も可能とし超薄膜から厚膜まで幅広い(数nm~1μm)成膜のコントロールが可能です。
・OER技術はプリカーサ(ソースガス)を効率的な反応(ラジカル化)ができるため、側壁の付プリカーサの効率的使用が出来、かつ側壁の付着物を膜内に巻き込む可能性がないたチャンバー内の汚損の極小化を可能とします。
《装置イメージ図》
従来型ALD成膜方式
常温OER-ALD成膜(本技術適用イメージ)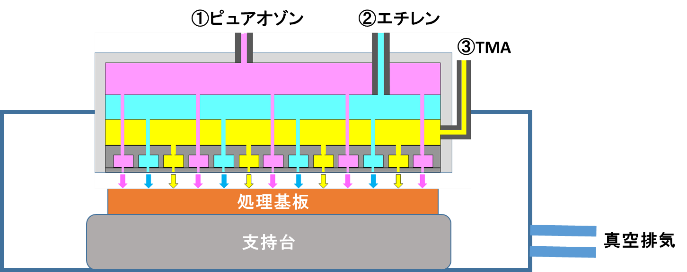
ピュアオゾンジェネレータとは
ピュアオゾンガス(濃度100%)連続発生装置で、2000年に開発を着手し2007年から発売を開始しました。現在は主に半導体製造装置メーカー向けに出荷しており、毒性、爆発性のあるオゾンガスを安全に安定供給できる装置です。
本件及び取材に関するお問い合わせ先
株式会社 明電舎 広報・IR部 広報課
電話 03-6420-8100



