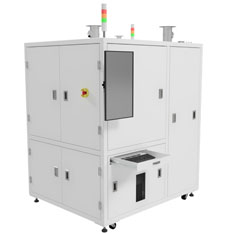

常温成膜装置 バッチ式PO-ALD装置
(立体物・複数一括処理)
対象物に熱ダメージ・プラズマダメージを与えることなく、常温で立体物や粉体に原子レベルの緻密な成膜をすることができる装置。
製品特長
PO-ALD装置はピュアオゾンを使用した、世界で初めてのバッチ式低温成膜装置です。
- バッチ成膜:バッチ処理にて高い生産性を実現
世界初となるピュアオゾンガスの長寿命を活用した画期的な成膜技術にて同時成膜が可能 - 常温成膜:基材非加熱かつプラズマレスで基材へのダメージなし
ピュアオゾンガスの反応性の高さにより、プラズマでは実現できない常温(30~150℃)成膜が可能 - 高トレンチ成膜:様々な形状(凹凸,両面,粉体)への均一な成膜が可能
ピュアオゾンガスの回り込み性の高さより、従来オゾン比4倍の被覆段差性を実現 - 低ランニングコスト:高いガス利用効率、低排出ガスのプロセス
汎用的な原料ガス(プリカーサ)を利用。高いガス利用効率により、従来技術比で低ランニングコストを実現
用途・ソリューション
適用分野と用途例
処理空間内に暴露している表面全てに成膜できる特徴を生かした、25枚注2成のウェハーの同時成膜が特長です。
光学レンズ等の反射防止膜(積層)、プリンターのインクジェットのバリア膜、OLED等のディスプレイへの保護膜用途等への活用が期待できます。
注2:25枚は一例です。成膜枚数はご相談可能
| 分野 | 用途例 | 膜種SiO2 | 膜種TiO2 | 膜種Al2O3 | 要求性能 | ||
|---|---|---|---|---|---|---|---|
光学デバイス |
LED | 保護膜 | 反射防止コート | 〇 |
〇 |
屈折率、高アスペクト比、光透過性 | |
光学製品 |
偏光板 | ナノインプリント | 〇 |
屈折率、高アスペクト比 | |||
ディスプレイ、FPD |
OLED(有機EL) | マイクロLED | 保護膜 | 〇 |
〇 |
〇 |
水蒸気透過率、屈折率、高アスペクト比 |
光通信 |
可視光 | 〇 |
〇 |
屈折率、膜厚分布 | |||
プリンタ |
インクジェット | 〇 |
水蒸気透過率、高アスペクト比 | ||||
メモリ、センサ、MEMS |
TSV(層間絶縁) | 3D IC | 保護膜 | 〇 |
高アスペクト比 | ||
パワーデバイス |
絶縁膜 | GaN-MOSFET | 〇 |
〇 |
絶縁性 | ||
電池、医療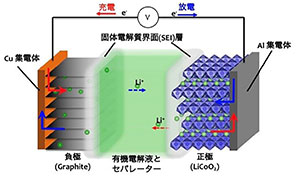 |
ナノコーティング | 〇 |
〇 |
膜中ピンホールフリー、膜厚分布高アスペクト比 | |||
仕様一覧
| 周囲温度 | 15~30℃、35~70%RH |
|---|---|
| サイズ | 1,350mm(W)× 1,650mm(D)× 1,945mm(H) |
| 成膜温度 | 50°C~150°C |
| 成膜対象 | ・ウエハー:12インチ以下(最大100枚) ・基材(ガラス、樹脂):Φ300(あるいは□210mm)(100枚) ・粉体:粒径1um以上 ・立体物(凹凸) |
| ステージ | 回転機構(10rpm~100rpm) |
| 基板交換方式 | 炉ハッチ開閉(手動)、基板固定具の交換 |
| 膜種 | SiO2、TiO2、Al2O3、HfO2(計画中)、ZrO3(計画中) Oプラズマや水プラズマで可能なすべての酸化膜 |
| オプション | ・用途別推奨成膜レシピ表示機能 ・防着版クリーニング時期自動喚起機能 ・膜厚モニター機能 |
| 必要な付帯設備 | ・電源(3相交流200V) ・圧縮空気(空圧バルブの動作用) ・高純度酸素 ・プロセス用高純度アルゴンガス ・パージ用高純度窒素 ・原料液化ガス ・排気ガス回収口 ・筐体排気ダクト ・冷却水 |
| 膜種 | SiO2 | TiO2 | AL2O3 |
|---|---|---|---|
| 成膜温度 | 30~150℃ | 50~150℃ | 30~150℃ |
| 成膜レート (Φ200基板の例) |
30nm <2Hr 100nm <6Hr |
30nm <6Hr 100nm <18Hr |
30nm <5Hr 100nm <17Hr |
| 面内膜厚分布 | ±1% | ±1% | ±1% |
| 高アスペクト比 | 高アスペクト比 40:1 95%以上 |
高アスペクト比 40:1 88%以上 |
高アスペクト比 40:1 82%以上 |
| 水蒸気透過率 | ー |
ー |
10-5 g/㎝2day以下 ※SiO2/Al2O3積層 |
| 屈折率 | 1.47(120℃時) | 2.09(120℃時) | 1.57(120℃時) |
- この製品に関するお問い合わせ
-
- 営業戦略室

