ALD用酸化源
ピュアオゾンをALD(原子層堆積)用酸化源として使用することには多くの利点があり、ALDプロセスにおいて非常に有用な酸化源となります。
接続実績
国内・海外 大手ALD装置採用・接続実績あり
低温成膜
常温~150℃の低温成膜が可能
バッチ成膜
高純度・高濃度・高寿命オゾンの特長を生かし、大型ALDチャンバーでのバッチ成膜が可能
各社ALD装置との接続実績

成膜実績
- バッチ式ALD装置メーカ
- 枚葉式ALD装置メーカ
低温成膜、成膜レートや生産性の向上を図れます。
ALD装置のご提案も可能です。お問い合わせください。
SiO₂膜の段差被覆性例
オゾンガスの回り込み性を生かし、高カバレッジなトレンチへの成膜が可能。
SiO2膜の段差被覆性(ステップカバレッジ)は90%以上となります。
基材のTOP、SIDE、BOTTOMへ均質な成膜ができます。
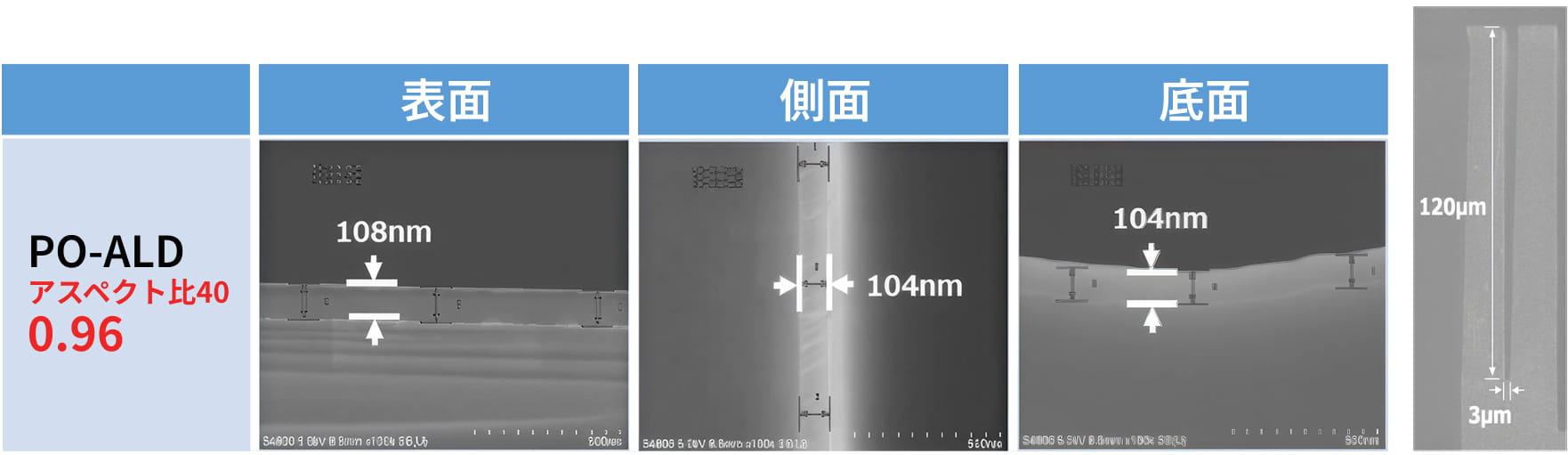
積層膜SiO₂/TiO₂断面構造
ALDの緻密な成膜手法を生かし、SiO₂とTiO₂の膜を交互に積層することができます。
ADF-STEM像
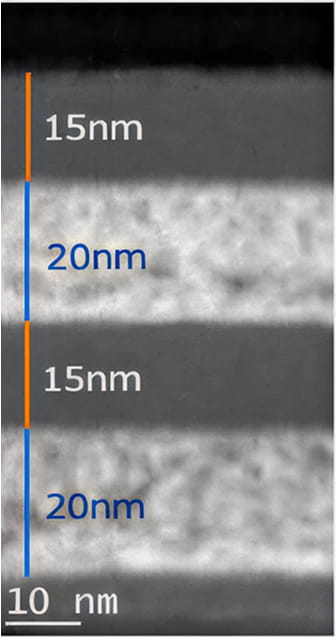
C-Kedge

O-Kedge

Si-L2,3edge

Si-L2,3edge

低温成膜
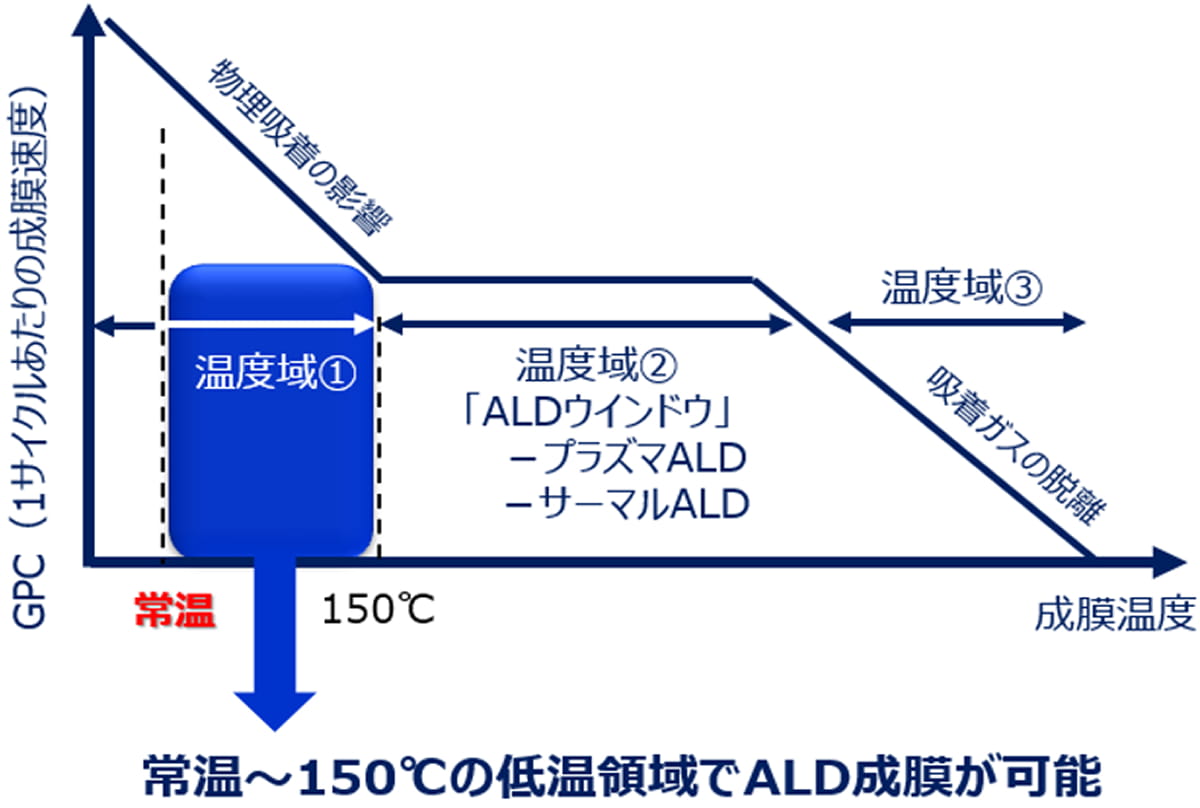
ALDウィンドウから外れた低温領域で成膜可能。
ALD(原子層堆積)プロセスにおける低温成膜は、特に熱に敏感な材料やフレキシブルデバイスの製造に最適です。
レジスト膜への成膜 (マルチパターニング)
常温でのオゾンではレジストの分解が起きない
⇒パターンを崩さずコンフォーマルな成膜が可能
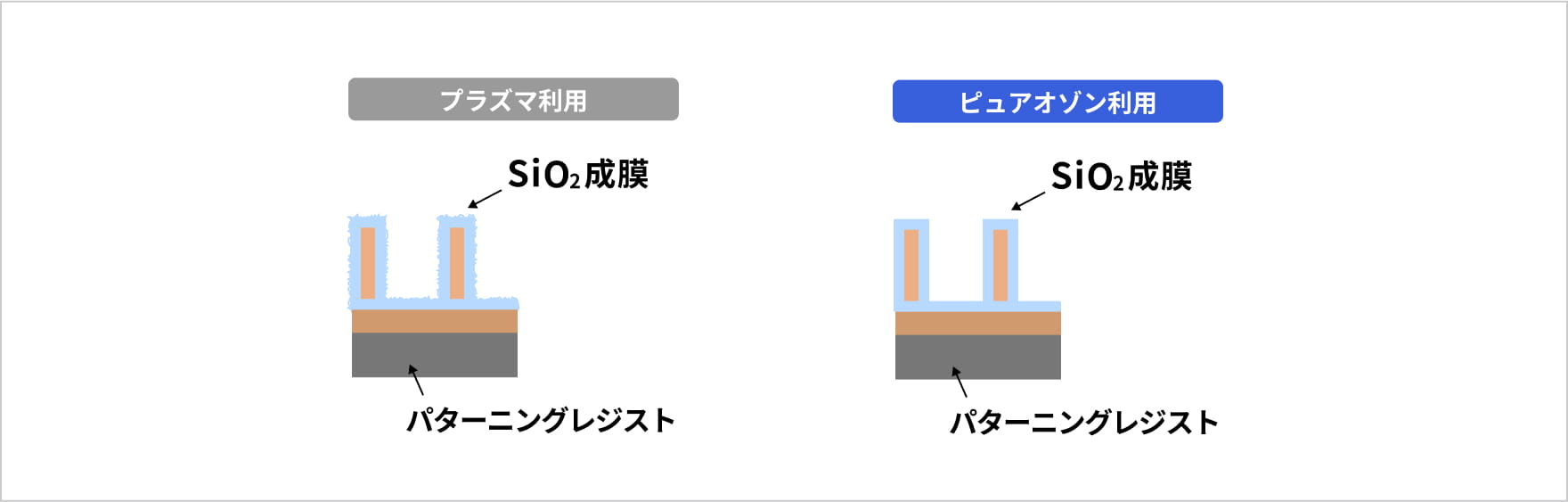
例)電気光学ポリマー 出典:NICT HPより
ピュアオゾンガスは金属汚染フリー
ピュアオゾンガス中に含まれる金属汚染なし。
次世代要素技術開発や、微細加工や超高純度工程において、メタル汚染のリスクを低減でき、製品製造の歩留まりや信頼性を向上が期待できます。
| 元素種 | Al | Ni | Cu | Mo |
|---|---|---|---|---|
| POG | <8.8×109
[atoms/㎠] 検出限界以下 |
<4.0×109
[atoms/㎠] 検出限界以下 |
<3.7×109
[atoms/㎠] 検出限界以下 |
<2.5×109
[atoms/㎠] 検出限界以下 |
成膜レート向上
SiO2成膜時のオゾナイザーとの性能比較(当社実験結果)
約1.7倍向上

酸素使用量の低減
ALDは「酸化ガス工程」にオゾン供給が必要
⇒POGは「酸化ガス工程」のみにオゾン供給可能
酸素使用量を約1/7に低減

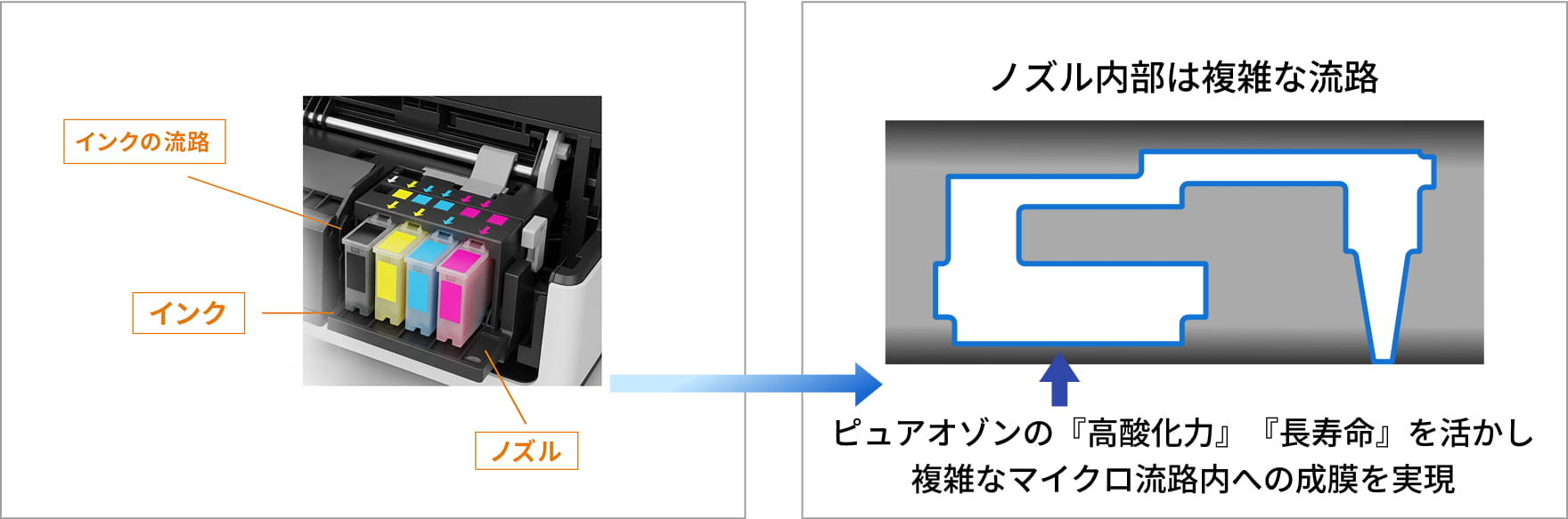
マイクロ流路へのALD成膜実績(インクジェットのノズルヘッド)
マイクロ流路やインクジェットのノズルヘッドなど、ピュアオゾンは狭い空間や複雑な形状にも均一に成膜する事ができます。トレンチ構造などの表面に均一な絶縁膜や保護膜を形成し、耐久性や性能を向上させることができます。
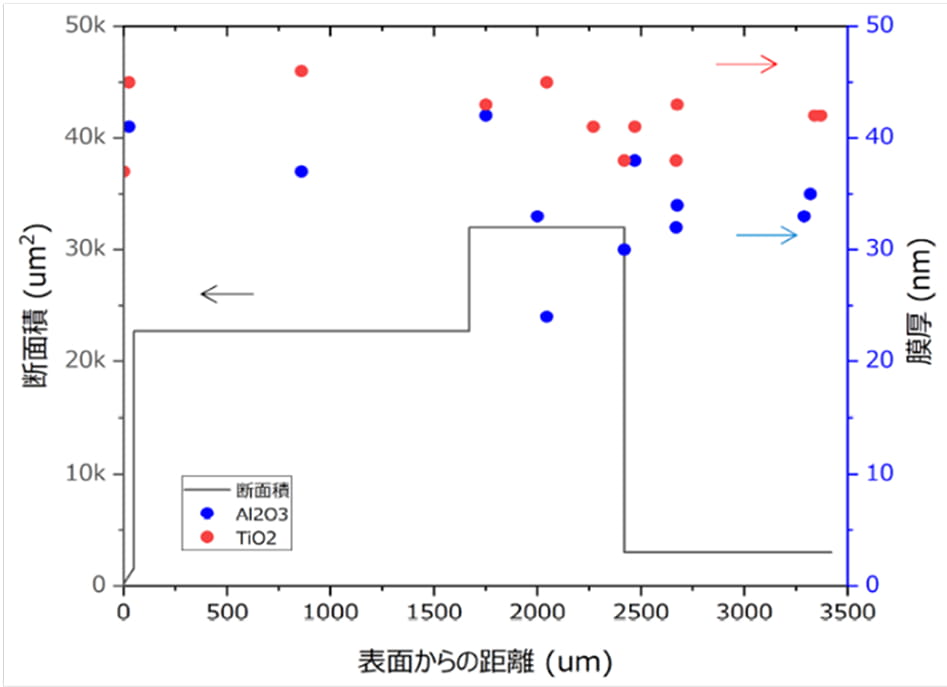
マイクロ流路への成膜結果(ご参考)※上図に示す流路イメージへの成膜結果ではありません。
